Молекулярно-лучевая эпитаксия, является разновидностью наращивания эпитаксиальных плёнок, представляющих собой чистый слой, практически полностью повторяющий форму подложки и её структуру. Эпитаксия широко распространена в промышленной сфере. Таким методом изготавливают диэлектрические, полупроводниковые провода и другие, используемые людьми предметы. После эпитаксиальной обработки, они становятся прочнее, устойчивее к повреждениям и получают особые свойства.
Что такое МЛЭ
Молекулярно-лучевой эпитаксией (МЛЭ), называют способ выращивания эпитаксиальной плевы на поверхности монокристаллической подложки. Она выполняется путём конденсации атомных, а иногда и молекулярных пучков, подающихся в камеру (содержащую в себе подложку) сквозь небольшое выходное отверстие сверхвакуумного устройства. В процессе МЛЭ участвует точечный испаритель, создающий давление из раскалённого пара.

Молекулярно-лучевая установка состоит из таких элементов:
- Аппаратуры для электронной дифракции, электроспектроскопии.
- Оже-микроанализатора.
- Масс-спектрометра для исследования ионов и паровой фазы.
- Источника ионов.
- Барокамеры для обработки сырья.
- Транспортёра, перемещающего кристалл между камерами.
Преимуществом эпитаксии МЛЭ, является низкоскоростной способ осаждения. Если применить для этого очищенные от загрязнений кристаллы, то выращенные эпитаксиальные слои, даже при низкой температуре исходного слитка будут идеальными. Также, низкоскоростной метод молекулярно-лучевой эпитаксии, даёт возможность делать многослойные слои (из 2-3 и более веществ). В современной промышленности научились создавать плёнки, нарощенные эпитаксиальным способом и имеющие толщину, менее микрометра.
Благодаря подобным научным достижениям появились:
- Структуры с плавно изменяющимся составом.
- Гетеропереходы.
- Сверхрешетки.
- Гетероструктуры.
Чтобы выполнить наращивание эпитаксиальных слоёв, следует использовать высококачественное промышленное оборудование, применяемое для исследований эпитаксии. Кроме того, специалисты до сих пор продолжают изучать, совершенствовать и создавать новые технологии наращивания эпитаксиальных многопереходных элементов нового типа.
Ионно-лучевая эпитаксиальная обработка
Лучевая эпитаксия довольно распространена и разделяется на несколько видов. Они используются, в зависимости от задачи, поставленной перед рабочими. Тогда на подложку распыляют ионные пучки инертных газов.
Лучевая эпитаксия может быть 2 видов:
- Ионная.
- Плазменная.
Ионно-лучевая и ионно-плазменная эпитаксия в некотором смысле схожи между собой. В обоих случаях на исходный кристалл распыляются пучки ионного инертного газа, но некоторые различия между ними имеются.
Широко распространено легирование при эпитаксиальном наращивание. Оно осуществляется по такому принципу:
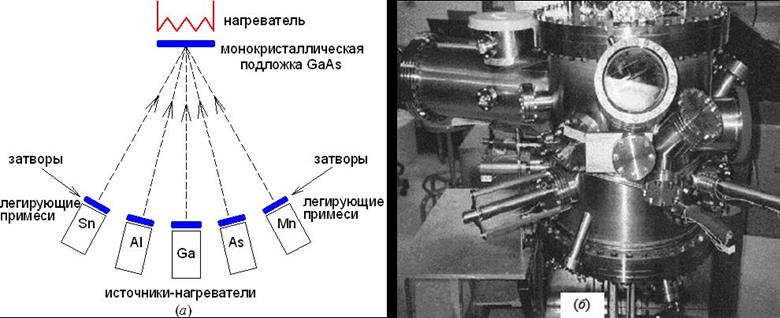
Преимущества ионно-лучевой эпитаксии, относительно ионно-плазменного распыления:
- Позволяет управлять зарядами в плёнке диэлектрического типа, благодаря нейтрализирующим электродам.
- Можно наносить сложносоставные слои, сохраняя компонентный состав исходной подложки.
- Не создаёт электрополей на подложке, что позволяет изготавливать высококачественные диэлектрические провода, даже из проводящего металла.
- Внутри рабочей барокамеры создаётся небольшое давление. Его обеспечивает скорость откачки вакуумизирующим устройством, а не специально созданные условия для поддержания заряда.
Начальное наращивание эпитаксиального слоя по технологии МЛЭ начинается с образования скопления атомов в различных участках исходного кристаллизованного материала. Их величина составляет около 10 ангстрем. Далее, количество данных зародышей увеличивается, также увеличивается их величина, что приводит к их смыканию в единое целое. Таким образом, формируется первичный слой многоатомной эпитаксиальной плевы, толщиной до 100А.
Получение равномерной эпитаксиальной плевы по технологии МЛЭ, является проблемой, ведь дефекты могут появиться, как на стадии зародыша, так и их смыкания. Возникновение, даже 1 дефекта может вызвать цепочную реакцию и увеличение концентрации дефектных участков.
Во избежание разориентации, при молекулярно-лучевой эпитаксии зародышей (даже на малые углы), следует придерживаться определённых требований к молекулярным источникам:
- Иметь запас материалов.
- Вещества должны быть чистыми.
- Рабочая скорость испарения – стабильной.
По технологии наращивания, нужно придерживаться вакуумного давления в пределах 1,33*10-6-1,33*10-8 Па и температурного режима – 400-800 градусов. Применяя данные параметры, скорость наращивания плевы будет достигать 0,01-0,03 микрометра в минуту, что можно приравнять к обработке из парогазовой фазы.
Электронно-лучевое эпитаксиальное наращивание
Электронно-лучевая эпитаксия выполняется по принципу молекулярно-лучевой обработки, но в этом случае используется классический способ, основанный на использовании твердофазных материалов: кремния, галлия и пр. Их распыление происходит, в результате испарения веществ пучком электронно-лучевой пушки или путём тигельного разогрева.
Сегодня в электронно-лучевой эпитаксии стала популярной технология, позволяющая изменять структуру эпитаксиальных слоёв.
Нарощенная эпитаксиальная плева может быть:
- Релаксированной.
- Напряжённой.
В рабочем режиме стало возможно преображать слои и делать из ненапряжённых напряжённые. Это можно делать двумя способами.
Первый (релаксационный).
Дальние наращиваемые слои и подложка сохранят свои структурные особенности.
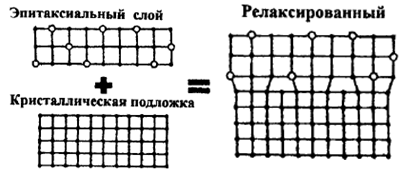
В процессе выращивания можно механическим путём нарушить 4-х сторонние атомные связи (в некоторых участках атомных соединений). Тогда определённое количество атомов будет иметь 1-3 оборванных связи. На гранях, где были оборваны соединения, формируются дислокационные несоответствия, приводящие к их проникновению в глубину нарощенной плевы. В итоге, сформировавшиеся дислокации могут служить, как электронные ловушки, являющиеся причиной деградации электрических и физических структурных особенностей.
Второй (Напряжённый).
При наращивании этим способом нарощенная плева деформируется, чтобы повторить параметры подложечной решётки (псевдоморфный рост).
 |
 |
|
При более высокой решёточной постоянности у слоя (относительно подложки), эпитаксиальная плева будет сжата вдоль растущей плоскости, сохраняя все связи. Стремительность компенсации напряжений стимулирует увеличение расстояния между плоскостями, в перпендикулярном к границе направлении. Энергетика упругих напряжений при этом сосредотачивается на эпитаксиальном слое.
Этим методом можно воссоздать из релаксирующего слоя напряжённый, поскольку при увеличении толщины наращиваемой плевы, возрастает и внутрислойная энергетика, но это до определённого момента. Состояния, перешедшие границу критического значения напряжения, становятся ненапряжёнными. Стоит отметить, что если структура, перешедшая из напряжённого состояния в ненапряжённое имеет разрушенные связи, расположенные по внутренней границе.

















